В мае этого года в одном из наиболее авторитетных научных журналов “Materials Science and Engineering R” (импакт-фактор 15) была опубликована обзорная статья нашего ведущего ученого профессора Александра Яковлевича Полякова и профессора Ин-Хван Ли из Чонбукского Национального университета в Корее.
Статья была посвящена влиянию дефектов на свойства нитридов III группы и обсуждению методов исследования электронной структуры этих дефектов.
Однако, по мере продвижения в практическую жизнь всё большее значения приобретают вопросы эффективности, надёжности и безотказности работы приборов на нитридах. И здесь выясняется, что нужно всерьёз разбираться с дефектами структуры в этих материалах и приборах и развивать новые методы их изучения. На эти и многие другие вопросы в своем экспертном мнении для нашего корпоративного блога ответит ведущий ученый профессор А.Я. Поляков.
*Хотелось бы предупредить наших читателей, что для полного осмысления изложенного необходимы знания в указанных областях.
Нитриды третьей группы Периодической таблицы Д.И. Менделеева – перспективнейшие полупроводниковые материалы, запрещённая зона которых позволяет, в принципе, получать излучатели и приёмники света с длиной волны от 1.55 мкм до 0.2 мкм, электронные приборы с очень большим напряжением пробоя и большим прямым током. Благодаря большой ширине запрещённой зоны и высокому значению энергии связи приборы на основе нитридов должны, в отличие от, скажем, кремния, хорошо работать при очень высоких температурах, выдерживать огромные дозы радиации, быть малочувствительными к воздействию агрессивных сред. Потенциал этих соединений был осознан очень давно, в конце 70-х годов. Однако практическим применениям мешали два очень важных недостатка. Во-первых, оказалось очень трудно получать объёмные кристаллы нитридов обычными методами, широко используемыми для других полупроводников. Это связано с высокими температурами плавления, высокой летучестью пара азота и низкой его растворимостью в расплаве. Тогда же, когда слои нитридов пытались выращивать на инородных подложках, получить монокристаллические эпитаксиальные плёнки, необходимые для создания электронных и оптоэлектронных приборов, не удавалось. Во-вторых, экспериментальные исследования на ранней стадии показали, что в этих полупроводниках не удаётся достигнуть проводимости р-типа, а концентрация электронов в слоях п-типа слишком высока.
Бурное развитие в области физики и технологии нитридов третьей группы началось с открытий японских учёных А. Акасаки, Х. Амано и, несколько позже, С. Накамуры, которые нашли способы получения монокристаллических плёнок нитрида галлия и контролируемого легирования этого материала на п-тип или р-тип проводимости. Для решения первой задачи был использован оригинальный приём, когда на инородную подложку (монокристаллический сапфир) сначала наносится при низкой температуре очень тонкий аморфный слой нитрида алюминия или нитрида галлия, отжигом при высокой температуре этот слой рекристаллизуется, превращаясь в текстуру мелких кристаллитов, а поверх уже выращивается при высокой температуре слой нитрида требуемого состава. Улучшение кристаллического совершенства происходит за счёт селективного латерального разрастания лишь небольшого числа зёрен с «правильной» ориентацией. Улучшение структурного совершенства плёнок позволило резко снизить концентрацию остаточных доноров в таких плёнках.
Решения же второй задачи получения устойчивой проводимости р-типа удалось добиться, когда было обнаружено, что главной причиной неудач в этом направлении является весьма эффективное образование комплексов водорода (всегда присутствующего в выращиваемых плёнках) с акцепторами. Оказалось, что если эти комплексы развалить с помощью облучения электронами или отжига при высокой температуре, проводимость дырочного типа в плёнках нитридов можно устойчиво получать. С этого момента основные слагаемые успеха оказались на месте и технология выращивания нитридов и приборов на их основе начала стремительно развиваться. К тому же выяснилось, что гетеропереходы нитридов обладают очень интересным свойством. Поскольку, в отличие от, скажем, кремния или арсенида галлия, образующих кубические кристаллы, нитриды кристаллизуются в гексагональной решётке, в них присутствует сильное поле электрической поляризации, которое приводит к образованию на гетерогранице двух разных нитридов (например, AlGaN/GaN) слоя двумерного электронного газа с очень высокой концентрацией, гораздо более высокой, чем в гетеропереходах AlGaAs/GaAs. Проводимостью этих двумерных электронов можно управлять, прилагая внешнее электрическое поле с помощью диода Шоттки.
Таким образом можно приготовить полевые транзисторы с огромной проводимостью канала (а значит, переносимым током во включённом состоянии), причём достигнуть этого без специального легирования слоя-источника электронов, просто за счёт так называемого поляризационного легирования (в гетеропереходах AlGaAs/GaAs требуется специально сильно легировать слой AlGaAs).
В результате в рекордные сроки были разработаны и продемонстрированы самые разнообразные приборы на основе нитридов: эффективные светодиоды, мощные полевые транзисторы, солнечно-слепые фотоприёмники (т.е. приёмники, реагирующие на ультрафиолетовое излучение, но не на видимый свет), выпрямители с маленькими потерями во включённом состоянии и большими пробивными напряжениями.
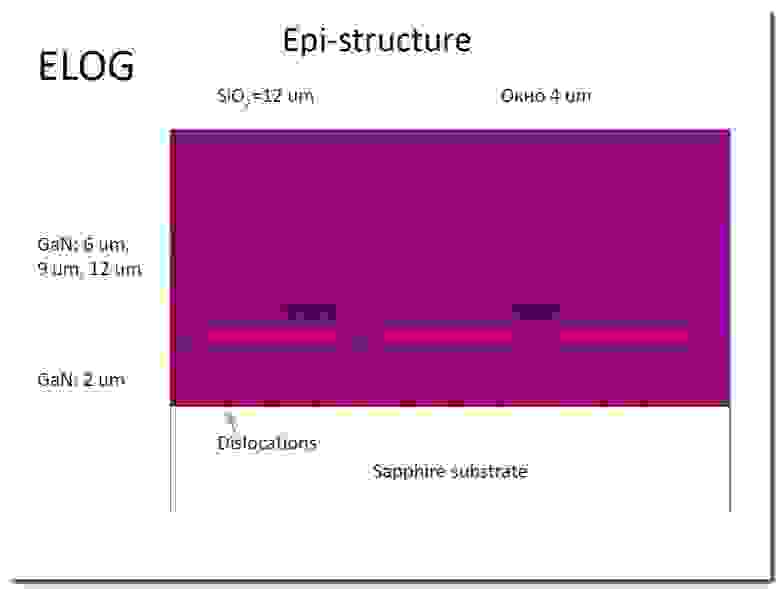
В гетеропереходах AlGaN/GaN удалось очень быстро получить огромную плотность двумерного электронного газа порядка 1013 см-2 и проводимость двумерного электронного газа на порядок более высокую, чем в гетеропереходах AlGaAs/GaAs только за счёт поляризационного легирования. Изготовленные в системе AlGaN/GaN полевые транзисторы (HEMTs) поэтому сразу доказали свои огромные преимущества. В обычных обстоятельствах светодиоды, инжекционные лазеры, выпрямители, полевые транзисторы весьма чувствительны к присутствию в слоях и на интерфейсах центров с глубокими уровнями, которые могут захватывать носители тока.
Возможность получения эффективной электролюминесценции в светодиодах на основе нитридов связали в этот период со спинодальным распадом твёрдых растворов InGaN, а низкий квантовый выход электролюминесценции в зелёной области спектра — с высокой концентрацией индия в квантовых ямах GaN/InGaN и большим размером областей выделения, обогащенных индием. Для HEMTs подход состоял в оптимизации поляризационного легирования. Исследованиям природы дефектов с глубокими уровнями в этот период отводилась чисто научная задача накопления знаний и сравнения с предсказаниями теоретических моделей.
Несколько позже выяснилось, что не всё так просто и глубокие центры, по-видимому, играют заметную роль в том, что светодиоды, изготовленные методом молекулярно-лучевой эпитаксии (МЛЭ), никогда не достигают эффективности, сравнимой с приборами, полученными МОС-гидридной эпитаксией (MOCVD), что характеристики неполярных светодиодов (т.е. светодиодов, приготовленных на структурах, в которых поляризационные поля равны нулю или малы) не оказываются выше, чем полярных (ожидался в этом случае большой выигрыш, связанный с тем, что поляризационные поля пространственно разделяют электроны и дырки в квантовых ямах и уменьшают эффективность излучательной рекомбинации), а характеристики светодиодов с нитридной полярностью (в гексагональной структуре, выращенной в направлении глав-ной гексагональной оси, оси с, верхняя и нижняя поверхность плёнки заканчиваются разными атомами, либо атомом III группы (самый распространённый вариант) либо азотом, см. Рис. 2), вопреки теоретическим соображениям, гораздо хуже, чем у приборов с галлиевой полярностью. Хотя во всех этих случаях причины эффектов достаточно сложны и многообразны, неизменно оказывалось, что и повышенная концентрация глубоких центров играет очень важную роль [1-4].

В последние же несколько лет выявился ряд обстоятельств, которые заставили совершенно иначе взглянуть на роль глубоких ловушек в поведении светодиодных, лазерных и транзисторных структур на основе нитридов.
Во-первых, считалось, что глубокие ловушки не могут быть важны для мощных светодиодов, потому что эти приборы работают при очень высоких значениях инжекционных токов, когда все ловушки насыщены и вклад их невелик. Однако выяснилось, что из-за эффектов Оже-рекомбинации (рекомбинация, в которой энергия идёт не на излучение, а передаётся третьей частице) и делокализации носителей в квантовых ямах инжекционные токи приходится сильно ограничивать, так что вклад центров безызлучательной рекомбинации становится очень заметным. На фоне очень возросших требований к величине внутреннего квантового выхода это обстоятельство приобретает большое значение.
Во-вторых, детальные структурные исследования последних лет не подтвердили образования локализованных областей квантовых точек в синих светодиодах на основе квантовых ям GaN/InGaN, а детальные измерения диффузионных длин (т.е. средних расстояний, которые могут проходить неравновесные электроны и дырки без рекомбинации) в нитриде галлия и светодиодах на его основе не подтверждают определяющей роли дислокаций. Тогда, естественно, встает вопрос, какие же центры ограничивают свойства?
В-третьих, в синих и зелёных неполярных и полярных светодиодных структурах в спектрах глубоких уровней обнаружен ряд глубоких центров, концентрация которых коррелирует с квантовой эффективностью и возрастает в процессе деградации (см. обсуждение этого вопроса в [5]). Более того, когда вклад этих центров в безызлучательную рекомбинацию удаётся подавить с помощью взаимодействия с локализованными поверхностными плазмонами (см. обзор в [6]), эффективность люминесценции резко возрастает.
Наконец, для полевых транзисторов на гетеропереходах уже очень давно известно явление коллапса тока (т.е. заметного уменьшения тока на больших частотах по сравнению с током при постоянном смещении), которое долгое время связывалось с захватом электронов на ловушки на поверхности барьера AlGaN и образованием так называемого виртуального затвора (эти заряженные ловушки как бы увеличивают на время эффективную площадь диода Шоттки и уменьшают тем самым ток через канал транзистора). Однако в последнее время выяснилось, что эти ловушки возникают не столько на поверхности, сколько вблизи интерфейса AlGaN/GaN, что набор этих ловушек достаточно ограничен, а сами ловушки генерируются при пропускании через транзисторы больших рабочих токов или при облучении их высокоэнергетическими частицами (см. обзор и ссылки в [5]).
Таким образом, задача изучения спектров глубоких уровней непосредственно в приборных структурах на основе нитрида галлия (светодиодах, транзисторах, выпрямителях) стала в последнее время весьма актуальной. Однако при решении этой задачи следует иметь в виду несколько обстоятельств.
Во-первых, ширина запрещённой зоны даже в голубых светодиодах равна 2.7-2.8 эВ, так что глубина центров, лежащих вблизи середины запрещённой зоны, составляет около 1.4 эВ, тогда как в стандартном методе ёмкостной спекторскопии глубоких уровней (РСГУ) лишь с большим трудом можно зарегистрировать пики, соответствующие примерно 1-1.2 эВ от краев зон при благоприятных значениях сечений захвата. Можно, в принципе, расширить диапазон регистрируемых ловушек до 1.5-1.6 эВ, используя более высокотемпературные криостаты (см. например, работу [7] для SiC), но для приборов на основе нитрида галлия становятся критическими утечки диода Шоттки. Этот вопрос ещё острее для структур, работающих в УФ области спектра и для полевых транзисторов с широкозонным барьером AlGaN. Дополнительные осложнения создаёт и большая глубина магниевых акцепторов (0.18 эВ), затрудняющая измерения на р-п переходах. Это затруднение ещё заметно растёт при росте мольной доли алюминия в УФ светодиодах. Серьёзную проблему представляет и явно выраженное туннелирование в структурах с квантовыми ямами (см. например, [8,9] и подробное обсуждение с большим количеством ссылок в обзоре [5]). В транзисторных структурах к серьёзным трудностям приводит присутствие метастабильных дефектов (т.е. дефектов, чьё состояние зависит от предыстории) в барьере транзистора. Эти дефекты сдвигают пороговое напряжение в процессе измерения спектров. Существенные затруднения вызывает также большое последовательное сопротивление для транзисторов в режиме обеднения [5]. (Оно связано с ростом сопротивления при выключении при обеднении слоя двумерного газа под барьером Шоттки, как это иллюстрирует Рис. 3).
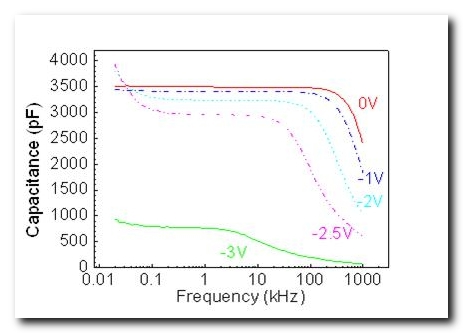
В последнее время опубликовано некоторое количество работ, которые позволяют отчасти решить указанные проблемы. В частности, в работе [10] и ряде других наших работах показано, как можно определить параметры глубоких ловушек в барьере из измерений спектральных зависимостей вольт-фарадных характеристик HEMT-структур при низких температурах и из адмиттанс-спектров структур (т.е. из измерения температурных зависимостей ёмкости и проводимости при различных частотах). В той же работе и в ряде других работ описаны измерения спектров РСГУ непосредственно на транзисторных структурах с многопальцевым затвором (схема иллюстрируется Рис. 4).
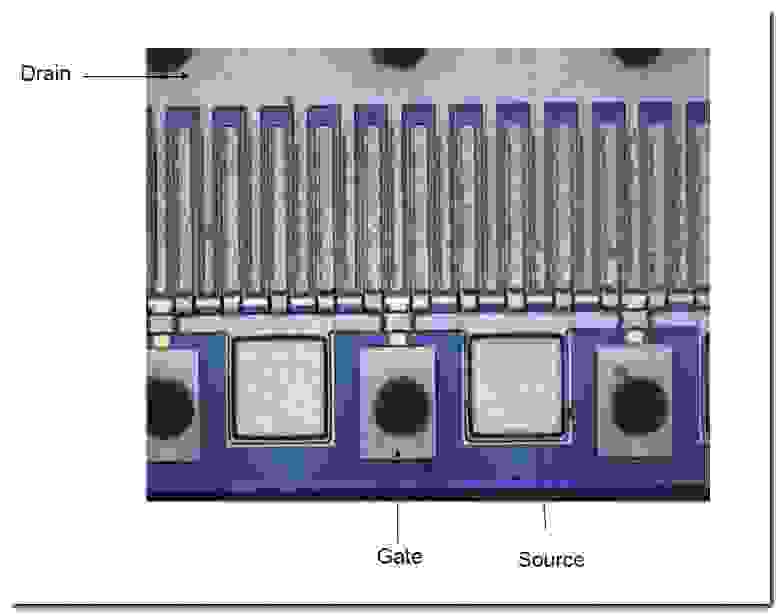
В случае структур, приготовленных на проводящем буфере, последний метод позволяет в принципе разделить ловушки, находящиеся в барьере и в буфере транзистора. В ряде работ (см., например, [11,12]) описаны два варианта токового РСГУ применительно к транзисторным структурам, позволяющие разделить ловушки в барьерном слое транзистора и на поверхности между затвором и стоком. Другой метод измерения спектров глубоких уровней и определения положения уровней в светодиодных структурах с множественными квантовыми ямами и в транзисторных структурах основан на комбинации варианта метода ёмкостной спектроскопии, в котором сканируется не температура, как в стандартном РСГУ, а длина волны возбуждающего света (метод DLOS), и эти измерения сочетаются с измерениями спектральных зависимостей вольт-фарадных характеристик (см. например, работы [13, 14]).
Недавно нами разработан метод емкостного РСГУ, позволяющий проводить измерения при различных частотах и тем самым минимизирующий эффекты последовательного сопротивления в транзисторах. Конкретная реализация метода позволяет также измерять спектры и при различных приложенных напряжениях «исток-сток» и, следовательно, достаточно эффективно различать интерфейсные и поверхностные ловушки [15]. Рис. 5 иллюстрирует исследованную структуру, а на Рис. 6 показано, что снижение частоты тестирующего сигнала с 1 МГц до 10 кГц позволяет выявить дополнительный центр 0.3 эВ у интерфейса структуры и правильно определить концентрацию других центров за счёт снижения влияния последовательного сопротивления.
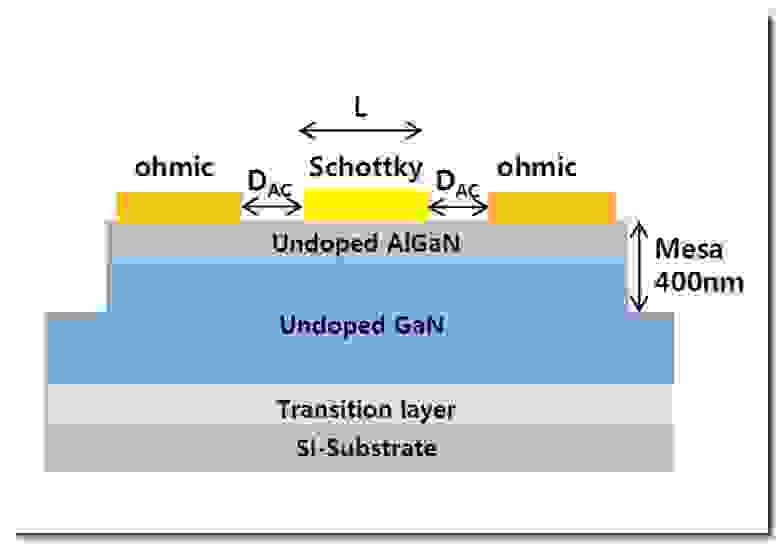
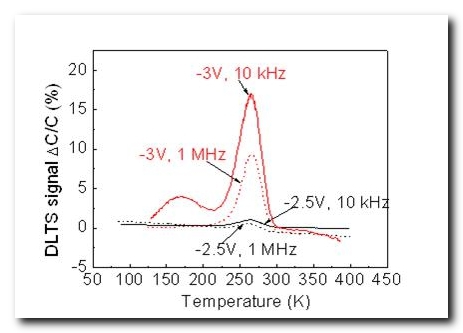
Общий подход к анализу характеристик ловушек, ответственных за коллапс тока в транзисторах и определению пространственного расположения этих ловушек описан в работах [16, 17] (среди многих других) и подробно обсуждается в нашем обзоре [5]. Все эти исследования и являются темой нашего проекта.
Статья была посвящена влиянию дефектов на свойства нитридов III группы и обсуждению методов исследования электронной структуры этих дефектов.
Как известно, эти полупроводниковые материалы являются основой для создания огромного класса новых полупроводниковых приборов – мощных белых светодиодов для систем общего освещения, голубых инжекционных лазеров для систем записи и считывания информации, монохроматических светодиодов с длинами волн во всем видимом диапазоне спектра (полноцветные рекламные щиты, дисплеи и индикаторы), ультрафиолетовые светодиоды (современные станции очистки воды, био-сенсоры, ускоренная полимеризация), СВЧ-транзисторов для ретрансляционных станций мобильной связи и современных радиолокаторов и многих других.Также отметим, что Нобелевская премия по физике в 2014 году была присуждена пионерам в этой области, японским учёным А. Акасаки, Х. Амано, С. Накамура за разработку голубых оптических диодов, позволивших внедрить яркие и энергосберегающие источники света, и как знак признания огромной важности данного направления. Но это только начало. Уже в скором времени в нашем быту светодиодные лампы на нитридах заменят традиционные лампы накаливания и флуоресцентные лампы.
Однако, по мере продвижения в практическую жизнь всё большее значения приобретают вопросы эффективности, надёжности и безотказности работы приборов на нитридах. И здесь выясняется, что нужно всерьёз разбираться с дефектами структуры в этих материалах и приборах и развивать новые методы их изучения. На эти и многие другие вопросы в своем экспертном мнении для нашего корпоративного блога ответит ведущий ученый профессор А.Я. Поляков.
*Хотелось бы предупредить наших читателей, что для полного осмысления изложенного необходимы знания в указанных областях.

 |
Александр Яковлевич Поляков Университет: Chonbuk National University, Южная Корея Приглашенный профессор, НИТУ «МИСиС» |
Бурное развитие в области физики и технологии нитридов третьей группы началось с открытий японских учёных А. Акасаки, Х. Амано и, несколько позже, С. Накамуры, которые нашли способы получения монокристаллических плёнок нитрида галлия и контролируемого легирования этого материала на п-тип или р-тип проводимости. Для решения первой задачи был использован оригинальный приём, когда на инородную подложку (монокристаллический сапфир) сначала наносится при низкой температуре очень тонкий аморфный слой нитрида алюминия или нитрида галлия, отжигом при высокой температуре этот слой рекристаллизуется, превращаясь в текстуру мелких кристаллитов, а поверх уже выращивается при высокой температуре слой нитрида требуемого состава. Улучшение кристаллического совершенства происходит за счёт селективного латерального разрастания лишь небольшого числа зёрен с «правильной» ориентацией. Улучшение структурного совершенства плёнок позволило резко снизить концентрацию остаточных доноров в таких плёнках.
Решения же второй задачи получения устойчивой проводимости р-типа удалось добиться, когда было обнаружено, что главной причиной неудач в этом направлении является весьма эффективное образование комплексов водорода (всегда присутствующего в выращиваемых плёнках) с акцепторами. Оказалось, что если эти комплексы развалить с помощью облучения электронами или отжига при высокой температуре, проводимость дырочного типа в плёнках нитридов можно устойчиво получать. С этого момента основные слагаемые успеха оказались на месте и технология выращивания нитридов и приборов на их основе начала стремительно развиваться. К тому же выяснилось, что гетеропереходы нитридов обладают очень интересным свойством. Поскольку, в отличие от, скажем, кремния или арсенида галлия, образующих кубические кристаллы, нитриды кристаллизуются в гексагональной решётке, в них присутствует сильное поле электрической поляризации, которое приводит к образованию на гетерогранице двух разных нитридов (например, AlGaN/GaN) слоя двумерного электронного газа с очень высокой концентрацией, гораздо более высокой, чем в гетеропереходах AlGaAs/GaAs. Проводимостью этих двумерных электронов можно управлять, прилагая внешнее электрическое поле с помощью диода Шоттки.
Таким образом можно приготовить полевые транзисторы с огромной проводимостью канала (а значит, переносимым током во включённом состоянии), причём достигнуть этого без специального легирования слоя-источника электронов, просто за счёт так называемого поляризационного легирования (в гетеропереходах AlGaAs/GaAs требуется специально сильно легировать слой AlGaAs).
В результате в рекордные сроки были разработаны и продемонстрированы самые разнообразные приборы на основе нитридов: эффективные светодиоды, мощные полевые транзисторы, солнечно-слепые фотоприёмники (т.е. приёмники, реагирующие на ультрафиолетовое излучение, но не на видимый свет), выпрямители с маленькими потерями во включённом состоянии и большими пробивными напряжениями.
Как известно, за революционные открытия в области физики нитридных соединений третьей группы А.Акасаки, Х. Амано и С. Накамура получили в прошлом году Нобелевскую премию по физике как признание огромной важности этих работ для науки и практики.Однако сразу оказалось, что свойства нитридов принципиально отличаются от свойств других полупроводников. Так, плотность дислокаций (линейных нарушений структуры, связанных с разницей параметров решётки и коэффициентов термического расширения, а также присутствием механических напряжений в структуре) в нитридах на пять порядков величины выше, чем, скажем, в арсениде галлия, тем не менее, в этой системе достаточно быстро удалось получить эффективные светодиоды на синюю область спектра, а позже и инжекционные лазеры, хотя в последнем случае и пришлось поработать над снижением плотности дислокаций с 109 до 107 см-2 с помощью использования методов селективного эпитаксиального заращивания (ELOG, Epitaxial Lateral Overgrowth в английской аббревиатуре, метод иллюстрируется Рис. 1, на котором показано, как происходит фильтрация проникающих дислокаций за счёт латерального роста над областями, замаскированными полосками SiO2).

Рис. 1. Схематическое представление метода ELOG, позволяющего снизить плотность дислокаций в слоях GaN для светодиодов и инжекционных лазеров
В гетеропереходах AlGaN/GaN удалось очень быстро получить огромную плотность двумерного электронного газа порядка 1013 см-2 и проводимость двумерного электронного газа на порядок более высокую, чем в гетеропереходах AlGaAs/GaAs только за счёт поляризационного легирования. Изготовленные в системе AlGaN/GaN полевые транзисторы (HEMTs) поэтому сразу доказали свои огромные преимущества. В обычных обстоятельствах светодиоды, инжекционные лазеры, выпрямители, полевые транзисторы весьма чувствительны к присутствию в слоях и на интерфейсах центров с глубокими уровнями, которые могут захватывать носители тока.
Казалось, что в не слишком совершенных слоях, гетеропереходах, квантовых ямах нитридов влияние этих глубоких ловушек будет сильнее, чем для высокосовершенных полупроводников.Однако проведённые в начальный период исследования спектров глубоких уровней в плёнках нитридов не продемонстрировали, вопреки ожиданиям, очень высоких концентраций глубоких центров и какой-то серьёзной связи каких-либо центров с характеристиками лазеров, светодиодов, транзисторов. Единственными дефектами, которые, как казалось, оказывают влияние на параметры, были дислокации. Поэтому внимание исследователей долгое время было привлечено в основном к получению структур с заданным набором слоёв, заданным уровнем их легирования, резкими гетерограницами и приемлемым для данного применения уровнем плотности дислокаций.
Возможность получения эффективной электролюминесценции в светодиодах на основе нитридов связали в этот период со спинодальным распадом твёрдых растворов InGaN, а низкий квантовый выход электролюминесценции в зелёной области спектра — с высокой концентрацией индия в квантовых ямах GaN/InGaN и большим размером областей выделения, обогащенных индием. Для HEMTs подход состоял в оптимизации поляризационного легирования. Исследованиям природы дефектов с глубокими уровнями в этот период отводилась чисто научная задача накопления знаний и сравнения с предсказаниями теоретических моделей.
Несколько позже выяснилось, что не всё так просто и глубокие центры, по-видимому, играют заметную роль в том, что светодиоды, изготовленные методом молекулярно-лучевой эпитаксии (МЛЭ), никогда не достигают эффективности, сравнимой с приборами, полученными МОС-гидридной эпитаксией (MOCVD), что характеристики неполярных светодиодов (т.е. светодиодов, приготовленных на структурах, в которых поляризационные поля равны нулю или малы) не оказываются выше, чем полярных (ожидался в этом случае большой выигрыш, связанный с тем, что поляризационные поля пространственно разделяют электроны и дырки в квантовых ямах и уменьшают эффективность излучательной рекомбинации), а характеристики светодиодов с нитридной полярностью (в гексагональной структуре, выращенной в направлении глав-ной гексагональной оси, оси с, верхняя и нижняя поверхность плёнки заканчиваются разными атомами, либо атомом III группы (самый распространённый вариант) либо азотом, см. Рис. 2), вопреки теоретическим соображениям, гораздо хуже, чем у приборов с галлиевой полярностью. Хотя во всех этих случаях причины эффектов достаточно сложны и многообразны, неизменно оказывалось, что и повышенная концентрация глубоких центров играет очень важную роль [1-4].

Рис. 2. Азотная и галлиевая полярности в нитриде галлия и способы их получения
В последние же несколько лет выявился ряд обстоятельств, которые заставили совершенно иначе взглянуть на роль глубоких ловушек в поведении светодиодных, лазерных и транзисторных структур на основе нитридов.
Во-первых, считалось, что глубокие ловушки не могут быть важны для мощных светодиодов, потому что эти приборы работают при очень высоких значениях инжекционных токов, когда все ловушки насыщены и вклад их невелик. Однако выяснилось, что из-за эффектов Оже-рекомбинации (рекомбинация, в которой энергия идёт не на излучение, а передаётся третьей частице) и делокализации носителей в квантовых ямах инжекционные токи приходится сильно ограничивать, так что вклад центров безызлучательной рекомбинации становится очень заметным. На фоне очень возросших требований к величине внутреннего квантового выхода это обстоятельство приобретает большое значение.
Во-вторых, детальные структурные исследования последних лет не подтвердили образования локализованных областей квантовых точек в синих светодиодах на основе квантовых ям GaN/InGaN, а детальные измерения диффузионных длин (т.е. средних расстояний, которые могут проходить неравновесные электроны и дырки без рекомбинации) в нитриде галлия и светодиодах на его основе не подтверждают определяющей роли дислокаций. Тогда, естественно, встает вопрос, какие же центры ограничивают свойства?
В-третьих, в синих и зелёных неполярных и полярных светодиодных структурах в спектрах глубоких уровней обнаружен ряд глубоких центров, концентрация которых коррелирует с квантовой эффективностью и возрастает в процессе деградации (см. обсуждение этого вопроса в [5]). Более того, когда вклад этих центров в безызлучательную рекомбинацию удаётся подавить с помощью взаимодействия с локализованными поверхностными плазмонами (см. обзор в [6]), эффективность люминесценции резко возрастает.
Наконец, для полевых транзисторов на гетеропереходах уже очень давно известно явление коллапса тока (т.е. заметного уменьшения тока на больших частотах по сравнению с током при постоянном смещении), которое долгое время связывалось с захватом электронов на ловушки на поверхности барьера AlGaN и образованием так называемого виртуального затвора (эти заряженные ловушки как бы увеличивают на время эффективную площадь диода Шоттки и уменьшают тем самым ток через канал транзистора). Однако в последнее время выяснилось, что эти ловушки возникают не столько на поверхности, сколько вблизи интерфейса AlGaN/GaN, что набор этих ловушек достаточно ограничен, а сами ловушки генерируются при пропускании через транзисторы больших рабочих токов или при облучении их высокоэнергетическими частицами (см. обзор и ссылки в [5]).
Таким образом, задача изучения спектров глубоких уровней непосредственно в приборных структурах на основе нитрида галлия (светодиодах, транзисторах, выпрямителях) стала в последнее время весьма актуальной. Однако при решении этой задачи следует иметь в виду несколько обстоятельств.
Во-первых, ширина запрещённой зоны даже в голубых светодиодах равна 2.7-2.8 эВ, так что глубина центров, лежащих вблизи середины запрещённой зоны, составляет около 1.4 эВ, тогда как в стандартном методе ёмкостной спекторскопии глубоких уровней (РСГУ) лишь с большим трудом можно зарегистрировать пики, соответствующие примерно 1-1.2 эВ от краев зон при благоприятных значениях сечений захвата. Можно, в принципе, расширить диапазон регистрируемых ловушек до 1.5-1.6 эВ, используя более высокотемпературные криостаты (см. например, работу [7] для SiC), но для приборов на основе нитрида галлия становятся критическими утечки диода Шоттки. Этот вопрос ещё острее для структур, работающих в УФ области спектра и для полевых транзисторов с широкозонным барьером AlGaN. Дополнительные осложнения создаёт и большая глубина магниевых акцепторов (0.18 эВ), затрудняющая измерения на р-п переходах. Это затруднение ещё заметно растёт при росте мольной доли алюминия в УФ светодиодах. Серьёзную проблему представляет и явно выраженное туннелирование в структурах с квантовыми ямами (см. например, [8,9] и подробное обсуждение с большим количеством ссылок в обзоре [5]). В транзисторных структурах к серьёзным трудностям приводит присутствие метастабильных дефектов (т.е. дефектов, чьё состояние зависит от предыстории) в барьере транзистора. Эти дефекты сдвигают пороговое напряжение в процессе измерения спектров. Существенные затруднения вызывает также большое последовательное сопротивление для транзисторов в режиме обеднения [5]. (Оно связано с ростом сопротивления при выключении при обеднении слоя двумерного газа под барьером Шоттки, как это иллюстрирует Рис. 3).

Рис. 3. Изменение граничной частоты «полки» в частотной зависимости ёмкости HEMT структуры AlGaN/GaN, свидетельствующее о возрастании последовательного сопротивления (access resistance)
В последнее время опубликовано некоторое количество работ, которые позволяют отчасти решить указанные проблемы. В частности, в работе [10] и ряде других наших работах показано, как можно определить параметры глубоких ловушек в барьере из измерений спектральных зависимостей вольт-фарадных характеристик HEMT-структур при низких температурах и из адмиттанс-спектров структур (т.е. из измерения температурных зависимостей ёмкости и проводимости при различных частотах). В той же работе и в ряде других работ описаны измерения спектров РСГУ непосредственно на транзисторных структурах с многопальцевым затвором (схема иллюстрируется Рис. 4).

Рис. 4. Многопальцевый затвор транзистора AlGaN/GaN, позволяющий проводить измерения спектров глубоких уровней в различных частях структуры стандартным методом РСГУ.
В случае структур, приготовленных на проводящем буфере, последний метод позволяет в принципе разделить ловушки, находящиеся в барьере и в буфере транзистора. В ряде работ (см., например, [11,12]) описаны два варианта токового РСГУ применительно к транзисторным структурам, позволяющие разделить ловушки в барьерном слое транзистора и на поверхности между затвором и стоком. Другой метод измерения спектров глубоких уровней и определения положения уровней в светодиодных структурах с множественными квантовыми ямами и в транзисторных структурах основан на комбинации варианта метода ёмкостной спектроскопии, в котором сканируется не температура, как в стандартном РСГУ, а длина волны возбуждающего света (метод DLOS), и эти измерения сочетаются с измерениями спектральных зависимостей вольт-фарадных характеристик (см. например, работы [13, 14]).
Недавно нами разработан метод емкостного РСГУ, позволяющий проводить измерения при различных частотах и тем самым минимизирующий эффекты последовательного сопротивления в транзисторах. Конкретная реализация метода позволяет также измерять спектры и при различных приложенных напряжениях «исток-сток» и, следовательно, достаточно эффективно различать интерфейсные и поверхностные ловушки [15]. Рис. 5 иллюстрирует исследованную структуру, а на Рис. 6 показано, что снижение частоты тестирующего сигнала с 1 МГц до 10 кГц позволяет выявить дополнительный центр 0.3 эВ у интерфейса структуры и правильно определить концентрацию других центров за счёт снижения влияния последовательного сопротивления.

Рис. 5. Исследованная структура

Рис. 6. Спектры РСГУ транзисторной структуры, измеренные при различных значениях напряжения на затворе и различных частотах тестирующего сигнала
Общий подход к анализу характеристик ловушек, ответственных за коллапс тока в транзисторах и определению пространственного расположения этих ловушек описан в работах [16, 17] (среди многих других) и подробно обсуждается в нашем обзоре [5]. Все эти исследования и являются темой нашего проекта.
Дополнительные материалы (сноски)
[1] A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, A.V. Markov, T.G Yugova, E.A. Petrova, H. Amano, T. Ka-washima, K.D. Scherbatchev, V.T. Bublik, Electrical Properties and Deep Traps Spectra in Undoped and Si-doped M-plane GaN Films, J. Appl. Phys. 105(6), 063708 (2009)
[2] A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, A.V. Markov, Q. Sun, Y. Zhang, C. D. Yerino, T.-S. Ko, I.-H. Lee, J. Han, Electrical properties and deep traps spectra of a-plane GaN films grown on r-plane sapphire, Materials Science and Engineering B, B166, 220-224 (2010)
[3]. A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, Q. Sun, Y. Zhang, Y.S. Cho, I.-H. Lee, J. Han, Electrical and luminescent properties and deep traps spectra of N-polar GaN films, Materials Science &Engineering B, 166, 81-88 (2010)
[4] A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, H. Amano, S.J. Pearton, I.-H. Lee, Q. Sun, J. Han and S.Yu. Karpov, Role of Non-Radiative Recombination Centers in Nonpolar GaN in Light Emission Efficiency and Relation to Extended Defects, Appl. Phys. Lett. 98, 072104 (2011)
[5] A.Y. Polyakov and In-Hwan Lee, Deep traps in GaN-based structures as affecting the performance of GaN devices (a review), Mat. Sci& Eng. ®, 94, 1-56 (2015)
[6] In-Hwan Lee, Lee-Woon Jang, and AlexanderY.Polyakov, Performance enhancement of GaN-based light emitting diodes by the interaction with localized surface plasmons, Nano Energy (a review) 13, 140–173 (2015)
[7]P.B. Klein, B.V. Shanabrook, S.W. Huh, A.Y. Polyakov, M. Skowronski, J.J. Shumakeris, and M.J. O’Loughlin, Lifetime-limiting defects in n- 4H-SiC epilayers, Appl. Phys. Lett. 88, 052110 (2006)
[8] A.Y. Polyakov, A.V. Govorkov, N.B. Smirnov, A.V. Markov, In-Hwan Lee, Jin-Woo Ju, S.Yu. Karpov, N.M. Shmidt, and S.J. Pearton, Properties of Undoped GaN/InGaN Multi-Quantum Wells and GaN/InGaN p-n Junctions Prepared By Epitaxial Lateral Overgrowth, J. Appl. Phys. 105, 123708 (2009)
[9] O. Soltanovich and E. Yakimov, Capacitance-voltage and admittance investigations of InGaN/GaN MQW LEDs: frequency dependence, Phys. Status Solidi (c ) 10, 338–341 (2013)
[10]A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, and E.A. Kozhukhova, S.J. Pearton, F. Ren and L. Lu, J.W. Johnson, R.V. Ryzhuk, N.I. Kargin, Deep traps in AlGaN/GaN heterojunctions and transistor structures grown on Si substrate, J. Vac. Sci. Technol. B 31, 011211 (2013)
[11] A. Sasikumar, A. R. Arehart, S. Martin-Horcajo, M. F. Romero, Y. Pei, D. Brown,
F. Recht, M. A. di Forte-Poisson, F. Calle, M. J. Tadjer, S. Keller, S. P. DenBaars,
U. K. Mishra, and S. A. Ringel, Direct comparison of traps in InAlN/GaN and AlGaN/GaN high electron mobility transistors using constant drain current deep level transient spectroscopy, Appl. Phys. Lett. 103, 033509 (2013)
[12] A.R. Arehart, A. Sasikumar, S. Rajan, G.D. Via, B. Poling, B. Winningham, E.R. Heller, D. Brown, Y. Pei, F. Recht, U.K. Mishra, and S.A. Ringel, Direct observation of 0.57 eV trap-related RF output power reduction in AlGaN/GaN high electron mobility transistors, Solid-State Electronics 80, 19–22 (2013)
[13] Y. Nakano, Y. Irokawa, and M. Takeguchi, Deep-Level Optical Spectroscopy Investigation of Band Gap States in AlGaN/GaN Hetero-Interfaces, Appl. Phys. Express, 1, 091101 (2008)
[14] A. Armstrong, T. A. Henry, D. D. Koleske, M. H. Crawford, K. R. Westlake, and S. R. Lee, Dependence of radiative efficiency and deep level defect incorporation
on threading dislocation density for InGaN/GaN light emitting diodes, Appl. Phys. Lett. 101, 162102 (2012)
[15] A.Y. Polyakov, N.B. Smirnov, In-Hwan Lee, and S.J. Pearton, Deep level transient spectroscopy in III-Nitrides: decreasing the effects of series resistance, to be published in J. Vac. Sci. Technol. (b) (2015)
[16] O. Mitrofanov and M. Manfra, Mechanisms of gate lag in GaN/AlGaN/GaN high
electron mobility transistors, Review, Superlattices and Microstructures 34, 33–53 (2003)
[17] J. Joh and J. A. del Alamo, A Current-Transient Methodology for Trap Analysis for GaN High Electron Mobility Transistors, IEEE Trans. Electron. Dev. 58, 132-140, (2011)
[2] A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, A.V. Markov, Q. Sun, Y. Zhang, C. D. Yerino, T.-S. Ko, I.-H. Lee, J. Han, Electrical properties and deep traps spectra of a-plane GaN films grown on r-plane sapphire, Materials Science and Engineering B, B166, 220-224 (2010)
[3]. A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, Q. Sun, Y. Zhang, Y.S. Cho, I.-H. Lee, J. Han, Electrical and luminescent properties and deep traps spectra of N-polar GaN films, Materials Science &Engineering B, 166, 81-88 (2010)
[4] A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, H. Amano, S.J. Pearton, I.-H. Lee, Q. Sun, J. Han and S.Yu. Karpov, Role of Non-Radiative Recombination Centers in Nonpolar GaN in Light Emission Efficiency and Relation to Extended Defects, Appl. Phys. Lett. 98, 072104 (2011)
[5] A.Y. Polyakov and In-Hwan Lee, Deep traps in GaN-based structures as affecting the performance of GaN devices (a review), Mat. Sci& Eng. ®, 94, 1-56 (2015)
[6] In-Hwan Lee, Lee-Woon Jang, and AlexanderY.Polyakov, Performance enhancement of GaN-based light emitting diodes by the interaction with localized surface plasmons, Nano Energy (a review) 13, 140–173 (2015)
[7]P.B. Klein, B.V. Shanabrook, S.W. Huh, A.Y. Polyakov, M. Skowronski, J.J. Shumakeris, and M.J. O’Loughlin, Lifetime-limiting defects in n- 4H-SiC epilayers, Appl. Phys. Lett. 88, 052110 (2006)
[8] A.Y. Polyakov, A.V. Govorkov, N.B. Smirnov, A.V. Markov, In-Hwan Lee, Jin-Woo Ju, S.Yu. Karpov, N.M. Shmidt, and S.J. Pearton, Properties of Undoped GaN/InGaN Multi-Quantum Wells and GaN/InGaN p-n Junctions Prepared By Epitaxial Lateral Overgrowth, J. Appl. Phys. 105, 123708 (2009)
[9] O. Soltanovich and E. Yakimov, Capacitance-voltage and admittance investigations of InGaN/GaN MQW LEDs: frequency dependence, Phys. Status Solidi (c ) 10, 338–341 (2013)
[10]A.Y. Polyakov, N.B. Smirnov, A.V. Govorkov, and E.A. Kozhukhova, S.J. Pearton, F. Ren and L. Lu, J.W. Johnson, R.V. Ryzhuk, N.I. Kargin, Deep traps in AlGaN/GaN heterojunctions and transistor structures grown on Si substrate, J. Vac. Sci. Technol. B 31, 011211 (2013)
[11] A. Sasikumar, A. R. Arehart, S. Martin-Horcajo, M. F. Romero, Y. Pei, D. Brown,
F. Recht, M. A. di Forte-Poisson, F. Calle, M. J. Tadjer, S. Keller, S. P. DenBaars,
U. K. Mishra, and S. A. Ringel, Direct comparison of traps in InAlN/GaN and AlGaN/GaN high electron mobility transistors using constant drain current deep level transient spectroscopy, Appl. Phys. Lett. 103, 033509 (2013)
[12] A.R. Arehart, A. Sasikumar, S. Rajan, G.D. Via, B. Poling, B. Winningham, E.R. Heller, D. Brown, Y. Pei, F. Recht, U.K. Mishra, and S.A. Ringel, Direct observation of 0.57 eV trap-related RF output power reduction in AlGaN/GaN high electron mobility transistors, Solid-State Electronics 80, 19–22 (2013)
[13] Y. Nakano, Y. Irokawa, and M. Takeguchi, Deep-Level Optical Spectroscopy Investigation of Band Gap States in AlGaN/GaN Hetero-Interfaces, Appl. Phys. Express, 1, 091101 (2008)
[14] A. Armstrong, T. A. Henry, D. D. Koleske, M. H. Crawford, K. R. Westlake, and S. R. Lee, Dependence of radiative efficiency and deep level defect incorporation
on threading dislocation density for InGaN/GaN light emitting diodes, Appl. Phys. Lett. 101, 162102 (2012)
[15] A.Y. Polyakov, N.B. Smirnov, In-Hwan Lee, and S.J. Pearton, Deep level transient spectroscopy in III-Nitrides: decreasing the effects of series resistance, to be published in J. Vac. Sci. Technol. (b) (2015)
[16] O. Mitrofanov and M. Manfra, Mechanisms of gate lag in GaN/AlGaN/GaN high
electron mobility transistors, Review, Superlattices and Microstructures 34, 33–53 (2003)
[17] J. Joh and J. A. del Alamo, A Current-Transient Methodology for Trap Analysis for GaN High Electron Mobility Transistors, IEEE Trans. Electron. Dev. 58, 132-140, (2011)